倒装技术技术细节
在半导体芯片倒装连接的过程中,有许多前后处理的工序,以下详细介绍倒装工艺的相关细节:
第一步:凸点下金属化(UBM,under bump metallization)
倒装连接第一步需在芯片表面制作凸点技术,倒装连接的本质是芯片上的凸点与基板上的凸点(凹槽)连接,半导体表面的金属化有以下几种方式:
(a)溅射:用溅射的方法一层一层地在硅片上沉积薄膜,然后通过照相平版技术形成UBM图样,然后刻蚀掉不是图样的部分。
(b)蒸镀:利用掩模,通过蒸镀的方法在硅片上一层一层地沉积。这种选择性的沉积用的掩模可用于对应的凸点的形成之中。
(c)化学镀:采用化学镀的方法在Al焊盘上选择性地镀Ni。常常用锌酸盐工艺对Al表面进行处理。无需真空及图样刻蚀设备,低成本。下图是半导体芯片进行凸点金属化(UBM)的流程:

由于铝焊盘表面有一层氧化物,镀层金属无法粘附在氧化的表面上,因此要对铝表面进行适当的处理以清除氧化物层。
一般的方法是在铝焊盘上采用锌酸盐处理(zincation),该技术是在铝的表面沉积一层锌,防止铝发生氧化,镀锌工艺的一个缺点是铝也会被镀液腐蚀掉,因此需要采用二次镀锌工艺,在进行镀锌工艺中,有0.3-0.4mm厚的铝将被腐蚀掉。在镀锌过程中,锌沉积在铝表面,而同时铝及氧化铝层则被腐蚀掉。锌保护铝不再发生氧化,锌层的厚度很薄。
在进行镀锌工艺后,进一步采用化学镀镍用作UBM的沉积,金属镍起到连接/扩散阻挡的作用。镍的扩散率非常小,与焊料也几乎不发生反应,它仅与锡有缓慢的反应,因此非常适合作为共晶焊料的UBM金属。化学镀镍既可以用于UBM金属的沉积,也可以用来形成凸点。在部分倒装凸点的表面会进一步镀金,由于金导电性能好,且不易氧化,可增加倒装连接的可靠性。
第二步: 回流形成凸点
焊料凸点方法有蒸镀焊料凸点、电镀焊料凸点、印刷焊料凸点、钉头焊料凸点、放球凸点、焊料转移凸点等不同工艺,其中电镀焊料及印刷焊料工艺使用较广泛。
在半导体表面凸点金属化后,通过回流炉将金属化部分形成倒装球。
回流形成凸点的大致过程如下图所示:
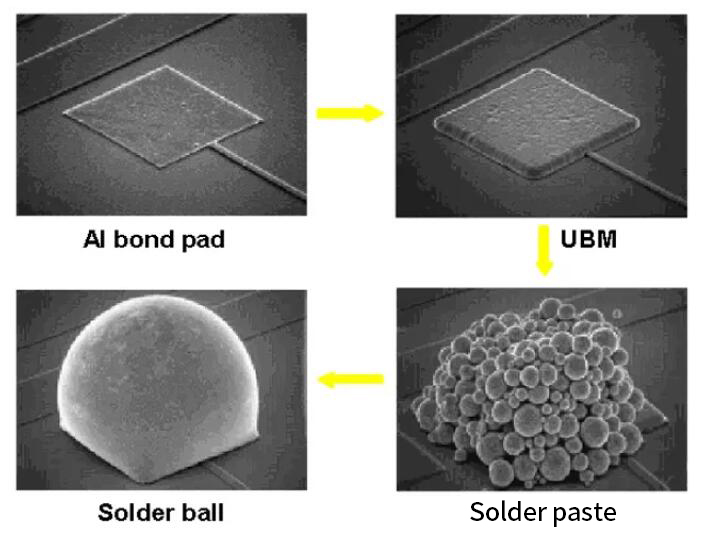
其中电镀焊料凸点的具体形成过程如下图:
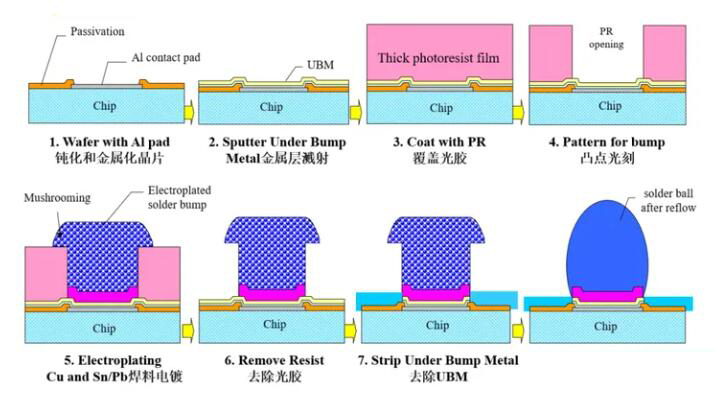
凸点常用的材料是Pb/Sn合金,因为其回流焊特性好,适合工业化生产。
除了常见的Pb/Sn合金,凸点也有Au/Ni合金等凸点材料,为了保证可靠的互连,UBM必须与用于凸点的焊料合金相容。适合高铅的UBM不一定适合高锡焊料。例如Cu润湿层合适于含锡3-5%的高铅焊料,但是不适合于高锡焊料,因为Cu与Sn反应迅速而生成Sn-Cu金属间化合物。如果Cu被消耗完毕,焊料将与焊区不润湿。
下图是不同的凸点材质件的倒装连接:
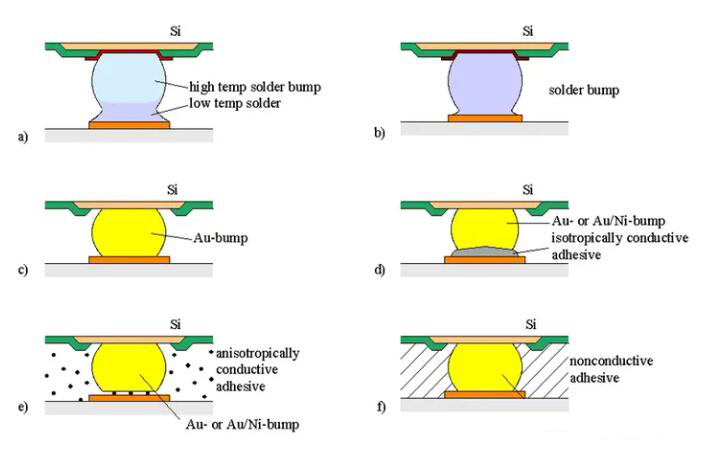
芯片表面形成的凸点在扫描电镜下观察到的外观如下图所示:
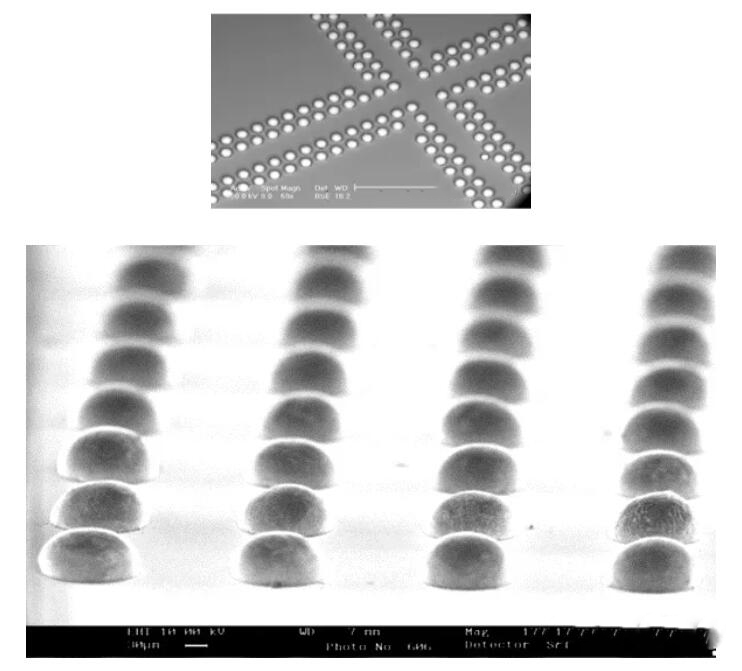
下图中的左图是回流(高温)前的凸点状态,右图是经高温后的凸点状态,经高温后凸点融化成球形。
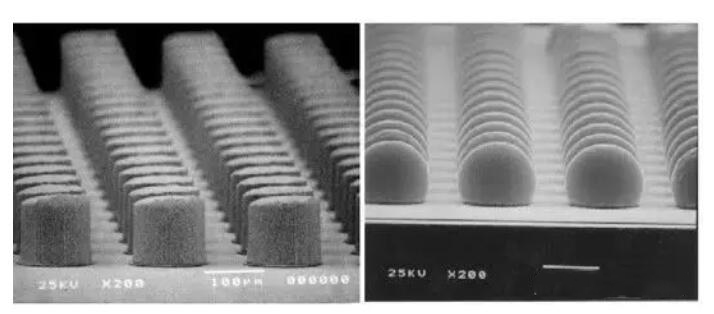
化学镀UBM和丝网印刷工艺(Electroless UBM and Stencil Printing)是工业应用中低成本倒装焊凸点制备方法。
以下是丝网印刷凸点制作流程(Stencil Printing Process Flow)及完成后的凸点形貌: